
Litografia a Fascio Elettronico
Il LaNN rappresenta una delle più importanti strutture di nanofabbricazione esistenti in Italia e dispone di diverse tecniche di caratterizzazione per la micro-nano litografia.
La litografia elettronica (EBL) è una tecnica che utilizza un fascio focalizzato di elettroni altamente energetici per scrivere pattern ad altissima risoluzione (≦ 8nm) su un substrato rivestito con un film sensibile (resist).
Il fascio scansiona l’immagine da esporre in accordo con un pattern precedentemente definito su un file CAD. Le strutture così definite vengono rivelate sviluppando successivamente il resist in un appropriato solvente.
Lo scopo, come nella fotolitografia, è quello di sfruttare il resist come stampo per le successive tecniche di trasferimento di pattern come il dry etching o il metal liftoff.
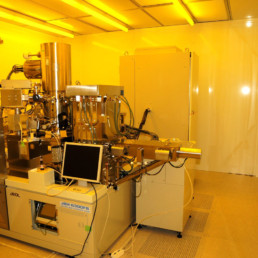
La tecnica EBL ha un vasto range di applicazioni e il LaNN può vantare una consolidata expertise nella realizzazione di:
- circuiti elettronici e fotonici integrati
- zone plates
- cristalli fotonici
- grating plasmonici
- master
- maschere
- sviluppo di speciali paradigmi di nanofabbricazione tridimensionale per la fabbricazione di dispositivi opto-elettronici innovativi (maschere di fase) ed ologrammi
Il laboratorio LaNN è dotato di un sistema EBL JEOL JBX-6300FS per Master & Mask Production e High Resolution Lithography:
- è in grado di scrivere su wafer da 3, 4 e 6 inch con una risoluzione ≦ 8nm, una overlay accuracy di 15nm ed una field stitching accuracy di 15nm;
- utilizza un DAC a 19bit, con un voltaggio di accelerazione selezionabile a 25kV, 50kV e 100kV;
- è provvisto di un caricatore automatico che garantisce la possibilità di funzionamento continuo non presidiato fino a 10 cassette in sequenza;
- è provvisto di software GenISys BEAMER per la correzione della prossimità.
- Tensioni di accelerazione: 100, 50, 25KV
- Corrente di probe elettronica: da 30pA a 20nA
- Dimensione minima del fascio: da 2 a 3nm nel modo ad alta risoluzione a 100KV
- Forma del fascio: spot beam
- Metodo di deflessione del fascio: vector scan
- Singolo campo di scrittura (max): a 100KV: 62.5um nel modo di scrittura ad alta risoluzione, 500um nel modo di scrittura ad alta velocità
- Velocità di scansione: fino a 12MHz
- Incremento di scansione: fino a 0.125nm (nel modo ad alta risoluzione a 100KV)
- DAC di posizionamento del fascio: 19 bits
- Precisione di posizionamento del fascio: 0.125nm
- Autoloader: caricamento automatico fino a 10 cassette
- Dimensione di scrittura wafer: fino a 6”
- Performance di scrittura: nel modo ad alta risoluzione a 100KV:
- minimum feature size: ≦ 8nm
- overlay accuracy: 15nm
- field stitching accuracy: 15nm
Referenti
Filippo Romanato: filippo.romanato@unipd.it
